
MEMS is the technology of microscopic devices incorporating both electronic and moving parts. MEMS are made up of components between 1 and 100 micrometres in size, and MEMS devices generally range in size from 20 micrometres to a millimetre, although components arranged in arrays can be more than 1000 mm2. They usually consist of a central unit that processes data and several components that interact with the surroundings.

Nitric acid is an inorganic compound with the formula HNO3. It is a highly corrosive mineral acid. The compound is colorless, but samples tend to acquire a yellow cast over time due to decomposition into oxides of nitrogen. Most commercially available nitric acid has a concentration of 68% in water. When the solution contains more than 86% HNO3, it is referred to as fuming nitric acid. Depending on the amount of nitrogen dioxide present, fuming nitric acid is further characterized as red fuming nitric acid at concentrations above 86%, or white fuming nitric acid at concentrations above 95%.

Semiconductor device fabrication is the process used to manufacture semiconductor devices, typically integrated circuits (ICs) such as microprocessors, microcontrollers, and memories. It is a multiple-step photolithographic and physico-chemical process during which electronic circuits are gradually created on a wafer, typically made of pure single-crystal semiconducting material. Silicon is almost always used, but various compound semiconductors are used for specialized applications.

Red fuming nitric acid (RFNA) is a storable oxidizer used as a rocket propellant. It consists of 84% nitric acid, 13% dinitrogen tetroxide and 1–2% water. The color of red fuming nitric acid is due to the dinitrogen tetroxide, which breaks down partially to form nitrogen dioxide. The nitrogen dioxide dissolves until the liquid is saturated, and produces toxic fumes with a suffocating odor. RFNA increases the flammability of combustible materials and is highly exothermic when reacting with water.

Hydrofluoric acid is a solution of hydrogen fluoride (HF) in water. Solutions of HF are colorless, acidic and highly corrosive. A common concentration is 49% (48-52%) but there are also stronger solutions and pure HF has a boiling point near room temperature. It is used to make most fluorine-containing compounds; examples include the commonly used pharmaceutical antidepressant medication fluoxetine (Prozac) and the material PTFE (Teflon). Elemental fluorine is produced from it. It is commonly used to etch glass and silicon wafers.

Ceric ammonium nitrate (CAN) is the inorganic compound with the formula (NH4)2[Ce(NO3)6]. This orange-red, water-soluble cerium salt is a specialised oxidizing agent in organic synthesis and a standard oxidant in quantitative analysis.

The planar process is a manufacturing process used in the semiconductor industry to build individual components of a transistor, and in turn, connect those transistors together. It is the primary process by which silicon integrated circuit chips are built, and it is the most commonly used method of producing junctions during the manufacture of semiconductor devices. The process utilizes the surface passivation and thermal oxidation methods.
Chemical mechanical polishing (CMP) is a process of smoothing surfaces with the combination of chemical and mechanical forces. It can be thought of as a hybrid of chemical etching and free abrasive polishing. It is used in the semiconductor industry to polish semiconductor wafers as part of the integrated circuit manufacturing process.

Ammonium fluoride is the inorganic compound with the formula NH4F. It crystallizes as small colourless prisms, having a sharp saline taste, and is highly soluble in water. Like all fluoride salts, it is moderately toxic in both acute and chronic overdose.

Lead(IV) oxide, commonly known as lead dioxide, is an inorganic compound with the chemical formula PbO2. It is an oxide where lead is in an oxidation state of +4. It is a dark-brown solid which is insoluble in water. It exists in two crystalline forms. It has several important applications in electrochemistry, in particular as the positive plate of lead acid batteries.
Porous silicon is a form of the chemical element silicon that has introduced nanopores in its microstructure, rendering a large surface to volume ratio in the order of 500 m2/cm3.
The etch pit density (EPD) is a measure for the quality of semiconductor wafers.

Piranha solution, also known as piranha etch, is a mixture of sulfuric acid and hydrogen peroxide. The resulting mixture is used to clean organic residues off substrates, for example silicon wafers. Because the mixture is a strong oxidizing agent, it will decompose most organic matter, and it will also hydroxylate most surfaces, making them highly hydrophilic (water-compatible). This means the solution can also easily dissolve fabric and skin, potentially causing severe damage and chemical burns in case of inadvertent contact. It is named after the piranha fish due to its tendency to rapidly dissolve and 'consume' organic materials through vigorous chemical reactions.
The RCA clean is a standard set of wafer cleaning steps which need to be performed before high-temperature processing steps of silicon wafers in semiconductor manufacturing.

Etching is used in microfabrication to chemically remove layers from the surface of a wafer during manufacturing. Etching is a critically important process module in fabrication, and every wafer undergoes many etching steps before it is complete.
Plasma-activated bonding is a derivative, directed to lower processing temperatures for direct bonding with hydrophilic surfaces. The main requirements for lowering temperatures of direct bonding are the use of materials melting at low temperatures and with different coefficients of thermal expansion (CTE).

Photolithography is a process in removing select portions of thin films used in microfabrication. Microfabrication is the production of parts on the micro- and nano- scale, typically on the surface of silicon wafers, for the production of integrated circuits, microelectromechanical systems (MEMS), solar cells, and other devices. Photolithography makes this process possible through the combined use of hexamethyldisilazane (HMDS), photoresist, spin coating, photomask, an exposure system and other various chemicals. By carefully manipulating these factors it is possible to create nearly any geometry microstructure on the surface of a silicon wafer. The chemical interaction between all the different components and the surface of the silicon wafer makes photolithography an interesting chemistry problem. Current engineering has been able to create features on the surface of silicon wafers between 1 and 100 μm.

Zirconium nitrate is a volatile anhydrous transition metal nitrate salt of zirconium with formula Zr(NO3)4. It has alternate names of zirconium tetranitrate, or zirconium(IV) nitrate.
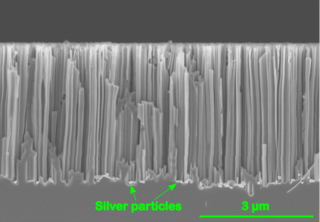
Metal Assisted Chemical Etching is the process of wet chemical etching of semiconductors with the use of a metal catalyst, usually deposited on the surface of a semiconductor in the form of a thin film or nanoparticles. The semiconductor, covered with the metal is then immersed in an etching solution containing and oxidizing agent and hydrofluoric acid. The metal on the surface catalyzes the reduction of the oxidizing agent and therefore in turn also the dissolution of silicon. In the majority of the conducted research this phenomenon of increased dissolution rate is also spatially confined, such that it is increased in close proximity to a metal particle at the surface. Eventually this leads to the formation of straight pores that are etched into the semiconductor. This means that a pre-defined pattern of the metal on the surface can be directly transferred to a semiconductor substrate.
Vapor etching refers to a process used in the fabrication of Microelectromechanical systems (MEMS) and Nanoelectromechanical systems (NEMS). Sacrificial layers are isotropically etched using gaseous acids such as Hydrogen fluoride and Xenon difluoride to release the free standing components of the device.