
Cathode rays or electron beams (e-beam) are streams of electrons observed in discharge tubes. If an evacuated glass tube is equipped with two electrodes and a voltage is applied, glass behind the positive electrode is observed to glow, due to electrons emitted from the cathode. They were first observed in 1859 by German physicist Julius Plücker and Johann Wilhelm Hittorf, and were named in 1876 by Eugen Goldstein Kathodenstrahlen, or cathode rays. In 1897, British physicist J. J. Thomson showed that cathode rays were composed of a previously unknown negatively charged particle, which was later named the electron. Cathode-ray tubes (CRTs) use a focused beam of electrons deflected by electric or magnetic fields to render an image on a screen.
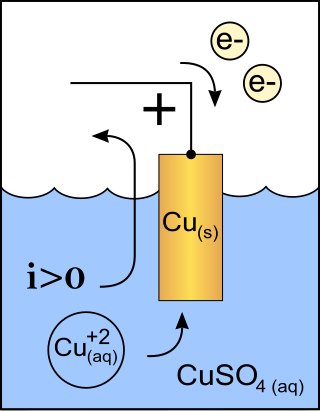
A cathode is the electrode from which a conventional current leaves a polarized electrical device. This definition can be recalled by using the mnemonic CCD for Cathode Current Departs. A conventional current describes the direction in which positive charges move. Electrons have a negative electrical charge, so the movement of electrons is opposite to that of the conventional current flow. Consequently, the mnemonic cathode current departs also means that electrons flow into the device's cathode from the external circuit. For example, the end of a household battery marked with a + (plus) is the cathode.

Electrochemistry is the branch of physical chemistry concerned with the relationship between electrical potential difference and identifiable chemical change. These reactions involve electrons moving via an electronically-conducting phase between electrodes separated by an ionically conducting and electronically insulating electrolyte.

MEMS is the technology of microscopic devices incorporating both electronic and moving parts. MEMS are made up of components between 1 and 100 micrometres in size, and MEMS devices generally range in size from 20 micrometres to a millimetre, although components arranged in arrays can be more than 1000 mm2. They usually consist of a central unit that processes data and several components that interact with the surroundings.

Corrosion is a natural process that converts a refined metal into a more chemically stable oxide. It is the gradual deterioration of materials by chemical or electrochemical reaction with their environment. Corrosion engineering is the field dedicated to controlling and preventing corrosion.

A flashtube (flashlamp) is an electric arc lamp designed to produce extremely intense, incoherent, full-spectrum white light for a very short time. A flashtube is a glass tube with an electrode at each end and is filled with a gas that, when triggered, ionizes and conducts a high-voltage pulse to make light. Flashtubes are used most in photography; they also are used in science, medicine, industry, and entertainment.

A glow discharge is a plasma formed by the passage of electric current through a gas. It is often created by applying a voltage between two electrodes in a glass tube containing a low-pressure gas. When the voltage exceeds a value called the striking voltage, the gas ionization becomes self-sustaining, and the tube glows with a colored light. The color depends on the gas used.

Electrophoretic deposition (EPD), is a term for a broad range of industrial processes which includes electrocoating, cathodic electrodeposition, anodic electrodeposition, and electrophoretic coating, or electrophoretic painting. A characteristic feature of this process is that colloidal particles suspended in a liquid medium migrate under the influence of an electric field (electrophoresis) and are deposited onto an electrode. All colloidal particles that can be used to form stable suspensions and that can carry a charge can be used in electrophoretic deposition. This includes materials such as polymers, pigments, dyes, ceramics and metals.
Plasma activation is a method of surface modification employing plasma processing, which improves surface adhesion properties of many materials including metals, glass, ceramics, a broad range of polymers and textiles and even natural materials such as wood and seeds. Plasma functionalization also refers to the introduction of functional groups on the surface of exposed materials. It is widely used in industrial processes to prepare surfaces for bonding, gluing, coating and painting. Plasma processing achieves this effect through a combination of reduction of metal oxides, ultra-fine surface cleaning from organic contaminants, modification of the surface topography and deposition of functional chemical groups. Importantly, the plasma activation can be performed at atmospheric pressure using air or typical industrial gases including hydrogen, nitrogen and oxygen. Thus, the surface functionalization is achieved without expensive vacuum equipment or wet chemistry, which positively affects its costs, safety and environmental impact. Fast processing speeds further facilitate numerous industrial applications.

Plasma-enhanced chemical vapor deposition (PECVD) is a chemical vapor deposition process used to deposit thin films from a gas state (vapor) to a solid state on a substrate. Chemical reactions are involved in the process, which occur after creation of a plasma of the reacting gases. The plasma is generally created by radio frequency (RF) frequency or direct current (DC) discharge between two electrodes, the space between which is filled with the reacting gases.

A radio-frequency microelectromechanical system is a microelectromechanical system with electronic components comprising moving sub-millimeter-sized parts that provide radio-frequency (RF) functionality. RF functionality can be implemented using a variety of RF technologies. Besides RF MEMS technology, III-V compound semiconductor, ferrite, ferroelectric, silicon-based semiconductor, and vacuum tube technology are available to the RF designer. Each of the RF technologies offers a distinct trade-off between cost, frequency, gain, large-scale integration, lifetime, linearity, noise figure, packaging, power handling, power consumption, reliability, ruggedness, size, supply voltage, switching time and weight.

A lithium-ion capacitor is a hybrid type of capacitor classified as a type of supercapacitor. It is called a hybrid because the anode is the same as those used in lithium-ion batteries and the cathode is the same as those used in supercapacitors. Activated carbon is typically used as the cathode. The anode of the LIC consists of carbon material which is often pre-doped with lithium ions. This pre-doping process lowers the potential of the anode and allows a relatively high output voltage compared to other supercapacitors.
A device generating linear or rotational motion using carbon nanotube(s) as the primary component, is termed a nanotube nanomotor. Nature already has some of the most efficient and powerful kinds of nanomotors. Some of these natural biological nanomotors have been re-engineered to serve desired purposes. However, such biological nanomotors are designed to work in specific environmental conditions. Laboratory-made nanotube nanomotors on the other hand are significantly more robust and can operate in diverse environments including varied frequency, temperature, mediums and chemical environments. The vast differences in the dominant forces and criteria between macroscale and micro/nanoscale offer new avenues to construct tailor-made nanomotors. The various beneficial properties of carbon nanotubes makes them the most attractive material to base such nanomotors on.
Direct bonding, or fusion bonding, describes a wafer bonding process without any additional intermediate layers. The bonding process is based on chemical bonds between two surfaces of any material possible meeting numerous requirements. These requirements are specified for the wafer surface as sufficiently clean, flat and smooth. Otherwise unbonded areas so called voids, i.e. interface bubbles, can occur.
Plasma-activated bonding is a derivative, directed to lower processing temperatures for direct bonding with hydrophilic surfaces. The main requirements for lowering temperatures of direct bonding are the use of materials melting at low temperatures and with different coefficients of thermal expansion (CTE).

Eutectic bonding, also referred to as eutectic soldering, describes a wafer bonding technique with an intermediate metal layer that can produce a eutectic system. Those eutectic metals are alloys that transform directly from solid to liquid state, or vice versa from liquid to solid state, at a specific composition and temperature without passing a two-phase equilibrium, i.e. liquid and solid state. The fact that the eutectic temperature can be much lower than the melting temperature of the two or more pure elements can be important in eutectic bonding.
Glass frit bonding, also referred to as glass soldering or seal glass bonding, describes a wafer bonding technique with an intermediate glass layer. It is a widely used encapsulation technology for surface micro-machined structures, e.g., accelerometers or gyroscopes. This technique utilizes low melting-point glass and therefore provides various advantages including that viscosity of glass decreases with an increase of temperature. The viscous flow of glass has effects to compensate and planarize surface irregularities, convenient for bonding wafers with a high roughness due to plasma etching or deposition. A low viscosity promotes hermetically sealed encapsulation of structures based on a better adaption of the structured shapes. Further, the coefficient of thermal expansion (CTE) of the glass material is adapted to silicon. This results in low stress in the bonded wafer pair. The glass has to flow and wet the soldered surfaces well below the temperature where deformation or degradation of either of the joined materials or nearby structures occurs. The usual temperature of achieving flowing and wetting is between 450 and 550 °C.
Reactive bonding describes a wafer bonding procedure using highly reactive nanoscale multilayer systems as an intermediate layer between the bonding substrates. The multilayer system consists of two alternating different thin metallic films. The self-propagating exothermic reaction within the multilayer system contributes the local heat to bond the solder films. Based on the limited temperature the substrate material is exposed, temperature-sensitive components and materials with different CTEs, i.e. metals, polymers and ceramics, can be used without thermal damage.
Research in lithium-ion batteries has produced many proposed refinements of lithium-ion batteries. Areas of research interest have focused on improving energy density, safety, rate capability, cycle durability, flexibility, and cost.

Aluminum electrolytic capacitors are (usually) polarized electrolytic capacitors whose anode electrode (+) is made of a pure aluminum foil with an etched surface. The aluminum forms a very thin insulating layer of aluminum oxide by anodization that acts as the dielectric of the capacitor. A non-solid electrolyte covers the rough surface of the oxide layer, serving in principle as the second electrode (cathode) (-) of the capacitor. A second aluminum foil called "cathode foil" contacts the electrolyte and serves as the electrical connection to the negative terminal of the capacitor.