
Fracture is the appearance of a crack or complete separation of an object or material into two or more pieces under the action of stress. The fracture of a solid usually occurs due to the development of certain displacement discontinuity surfaces within the solid. If a displacement develops perpendicular to the surface, it is called a normal tensile crack or simply a crack; if a displacement develops tangentially, it is called a shear crack, slip band, or dislocation.

In mechanics, compressive strength is the capacity of a material or structure to withstand loads tending to reduce size. In other words, compressive strength resists compression, whereas tensile strength resists tension. In the study of strength of materials, tensile strength, compressive strength, and shear strength can be analyzed independently.
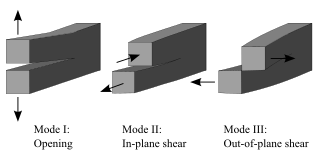
Fracture mechanics is the field of mechanics concerned with the study of the propagation of cracks in materials. It uses methods of analytical solid mechanics to calculate the driving force on a crack and those of experimental solid mechanics to characterize the material's resistance to fracture.
Thermal shock is a phenomenon characterized by a rapid change in temperature that results in a transient mechanical load on an object. The load is caused by the differential expansion of different parts of the object due to the temperature change. This differential expansion can be understood in terms of strain, rather than stress. When the strain exceeds the tensile strength of the material, it can cause cracks to form and eventually lead to structural failure.

Delamination is a mode of failure where a material fractures into layers. A variety of materials, including laminate composites and concrete, can fail by delamination. Processing can create layers in materials, such as steel formed by rolling and plastics and metals from 3D printing which can fail from layer separation. Also, surface coatings, such as paints and films, can delaminate from the coated substrate.

In fracture mechanics, the stress intensity factor is used to predict the stress state near the tip of a crack or notch caused by a remote load or residual stresses. It is a theoretical construct usually applied to a homogeneous, linear elastic material and is useful for providing a failure criterion for brittle materials, and is a critical technique in the discipline of damage tolerance. The concept can also be applied to materials that exhibit small-scale yielding at a crack tip.

In materials science, fracture toughness is the critical stress intensity factor of a sharp crack where propagation of the crack suddenly becomes rapid and unlimited. A component's thickness affects the constraint conditions at the tip of a crack with thin components having plane stress conditions and thick components having plane strain conditions. Plane strain conditions give the lowest fracture toughness value which is a material property. The critical value of stress intensity factor in mode I loading measured under plane strain conditions is known as the plane strain fracture toughness, denoted . When a test fails to meet the thickness and other test requirements that are in place to ensure plane strain conditions, the fracture toughness value produced is given the designation . Fracture toughness is a quantitative way of expressing a material's resistance to crack propagation and standard values for a given material are generally available.

The three-point bending flexural test provides values for the modulus of elasticity in bending , flexural stress , flexural strain and the flexural stress–strain response of the material. This test is performed on a universal testing machine with a three-point or four-point bend fixture. The main advantage of a three-point flexural test is the ease of the specimen preparation and testing. However, this method has also some disadvantages: the results of the testing method are sensitive to specimen and loading geometry and strain rate.
The J-integral represents a way to calculate the strain energy release rate, or work (energy) per unit fracture surface area, in a material. The theoretical concept of J-integral was developed in 1967 by G. P. Cherepanov and independently in 1968 by James R. Rice, who showed that an energetic contour path integral was independent of the path around a crack.

Ceramography is the art and science of preparation, examination and evaluation of ceramic microstructures. Ceramography can be thought of as the metallography of ceramics. The microstructure is the structure level of approximately 0.1 to 100 μm, between the minimum wavelength of visible light and the resolution limit of the naked eye. The microstructure includes most grains, secondary phases, grain boundaries, pores, micro-cracks and hardness microindentations. Most bulk mechanical, optical, thermal, electrical and magnetic properties are significantly affected by the microstructure. The fabrication method and process conditions are generally indicated by the microstructure. The root cause of many ceramic failures is evident in the microstructure. Ceramography is part of the broader field of materialography, which includes all the microscopic techniques of material analysis, such as metallography, petrography and plastography. Ceramography is usually reserved for high-performance ceramics for industrial applications, such as 85–99.9% alumina (Al2O3) in Fig. 1, zirconia (ZrO2), silicon carbide (SiC), silicon nitride (Si3N4), and ceramic-matrix composites. It is seldom used on whiteware ceramics such as sanitaryware, wall tiles and dishware.
Rubber toughening is a process in which rubber nanoparticles are interspersed within a polymer matrix to increase the mechanical robustness, or toughness, of the material. By "toughening" a polymer it is meant that the ability of the polymeric substance to absorb energy and plastically deform without fracture is increased. Considering the significant advantages in mechanical properties that rubber toughening offers, most major thermoplastics are available in rubber-toughened versions; for many engineering applications, material toughness is a deciding factor in final material selection.
Material failure theory is an interdisciplinary field of materials science and solid mechanics which attempts to predict the conditions under which solid materials fail under the action of external loads. The failure of a material is usually classified into brittle failure (fracture) or ductile failure (yield). Depending on the conditions most materials can fail in a brittle or ductile manner or both. However, for most practical situations, a material may be classified as either brittle or ductile.
In fracture mechanics, the energy release rate, , is the rate at which energy is transformed as a material undergoes fracture. Mathematically, the energy release rate is expressed as the decrease in total potential energy per increase in fracture surface area, and is thus expressed in terms of energy per unit area. Various energy balances can be constructed relating the energy released during fracture to the energy of the resulting new surface, as well as other dissipative processes such as plasticity and heat generation. The energy release rate is central to the field of fracture mechanics when solving problems and estimating material properties related to fracture and fatigue.

A compact tension specimen (CT) is a type of standard notched specimen in accordance with ASTM and ISO standards. Compact tension specimens are used extensively in the area of fracture mechanics and corrosion testing, in order to establish fracture toughness and fatigue crack growth data for a material.
Polymer fracture is the study of the fracture surface of an already failed material to determine the method of crack formation and extension in polymers both fiber reinforced and otherwise. Failure in polymer components can occur at relatively low stress levels, far below the tensile strength because of four major reasons: long term stress or creep rupture, cyclic stresses or fatigue, the presence of structural flaws and stress-cracking agents. Formations of submicroscopic cracks in polymers under load have been studied by x ray scattering techniques and the main regularities of crack formation under different loading conditions have been analyzed. The low strength of polymers compared to theoretically predicted values are mainly due to the many microscopic imperfections found in the material. These defects namely dislocations, crystalline boundaries, amorphous interlayers and block structure can all lead to the non-uniform distribution of mechanical stress.
In fracture mechanics, a crack growth resistance curve shows the energy required for crack extension as a function of crack length in a given material. For materials that can be modeled with linear elastic fracture mechanics (LEFM), crack extension occurs when the applied energy release rate exceeds the material's resistance to crack extension .

Crack tip opening displacement (CTOD) or is the distance between the opposite faces of a crack tip at the 90° intercept position. The position behind the crack tip at which the distance is measured is arbitrary but commonly used is the point where two 45° lines, starting at the crack tip, intersect the crack faces. The parameter is used in fracture mechanics to characterize the loading on a crack and can be related to other crack tip loading parameters such as the stress intensity factor and the elastic-plastic J-integral.

The Palmqvist method, or the Palmqvist toughness test, is a common method to determine the fracture toughness for cemented carbides. In this case, the material's fracture toughness is given by the critical stress intensity factor KIc.
In materials science, toughening refers to the process of making a material more resistant to the propagation of cracks. When a crack propagates, the associated irreversible work in different materials classes is different. Thus, the most effective toughening mechanisms differ among different materials classes. The crack tip plasticity is important in toughening of metals and long-chain polymers. Ceramics have limited crack tip plasticity and primarily rely on different toughening mechanisms.

A crack growth equation is used for calculating the size of a fatigue crack growing from cyclic loads. The growth of a fatigue crack can result in catastrophic failure, particularly in the case of aircraft. When many growing fatigue cracks interact with one another it is known as widespread fatigue damage. A crack growth equation can be used to ensure safety, both in the design phase and during operation, by predicting the size of cracks. In critical structure, loads can be recorded and used to predict the size of cracks to ensure maintenance or retirement occurs prior to any of the cracks failing. Safety factors are used to reduce the predicted fatigue life to a service fatigue life because of the sensitivity of the fatigue life to the size and shape of crack initiating defects and the variability between assumed loading and actual loading experienced by a component.