
Semiconductor device fabrication is the process used to manufacture semiconductor devices, typically integrated circuit (IC) "chips" such as computer processors, microcontrollers, and memory chips such as NAND flash and DRAM that are present in everyday electrical and electronic devices. It is a multiple-step sequence of photolithographic and physico-chemical processing steps during which electronic circuits are gradually created on a wafer typically made of pure single-crystal semiconducting material. Silicon is almost always used, but various compound semiconductors are used for specialized applications.

Solder is a fusible metal alloy used to create a permanent bond between metal workpieces. Solder is melted in order to wet the parts of the joint, where it adheres to and connects the pieces after cooling. Metals or alloys suitable for use as solder should have a lower melting point than the pieces to be joined. The solder should also be resistant to oxidative and corrosive effects that would degrade the joint over time. Solder used in making electrical connections also needs to have favorable electrical characteristics.

In microelectronics, a dual in-line package, is an electronic component package with a rectangular housing and two parallel rows of electrical connecting pins. The package may be through-hole mounted to a printed circuit board (PCB) or inserted in a socket. The dual-inline format was invented by Don Forbes, Rex Rice and Bryant Rogers at Fairchild R&D in 1964, when the restricted number of leads available on circular transistor-style packages became a limitation in the use of integrated circuits. Increasingly complex circuits required more signal and power supply leads ; eventually microprocessors and similar complex devices required more leads than could be put on a DIP package, leading to development of higher-density chip carriers. Furthermore, square and rectangular packages made it easier to route printed-circuit traces beneath the packages.

A printed circuit board is a medium used in electrical and electronic engineering to connect electronic components to one another in a controlled manner. It takes the form of a laminated sandwich structure of conductive and insulating layers: each of the conductive layers is designed with an artwork pattern of traces, planes and other features etched from one or more sheet layers of copper laminated onto and/or between sheet layers of a non-conductive substrate. Electrical components may be fixed to conductive pads on the outer layers in the shape designed to accept the component's terminals, generally by means of soldering, to both electrically connect and mechanically fasten them to it. Another manufacturing process adds vias: plated-through holes that allow interconnections between layers.

Wire bonding is the method of making interconnections between an integrated circuit (IC) or other semiconductor device and its packaging during semiconductor device fabrication. Although less common, wire bonding can be used to connect an IC to other electronics or to connect from one printed circuit board (PCB) to another. Wire bonding is generally considered the most cost-effective and flexible interconnect technology and is used to assemble the vast majority of semiconductor packages. Wire bonding can be used at frequencies above 100 GHz.

Ball bonding is a type of wire bonding, and is the most common way to make the electrical interconnections between a bare silicon die and the lead frame of the package it is placed in during semiconductor device fabrication.

A ball grid array (BGA) is a type of surface-mount packaging used for integrated circuits. BGA packages are used to permanently mount devices such as microprocessors. A BGA can provide more interconnection pins than can be put on a dual in-line or flat package. The whole bottom surface of the device can be used, instead of just the perimeter. The traces connecting the package's leads to the wires or balls which connect the die to package are also on average shorter than with a perimeter-only type, leading to better performance at high speeds.

Flip chip, also known as controlled collapse chip connection or its abbreviation, C4, is a method for interconnecting dies such as semiconductor devices, IC chips, integrated passive devices and microelectromechanical systems (MEMS), to external circuitry with solder bumps that have been deposited onto the chip pads. The technique was developed by General Electric's Light Military Electronics Department, Utica, New York. The solder bumps are deposited on the chip pads on the top side of the wafer during the final wafer processing step. In order to mount the chip to external circuitry, it is flipped over so that its top side faces down, and aligned so that its pads align with matching pads on the external circuit, and then the solder is reflowed to complete the interconnect. This is in contrast to wire bonding, in which the chip is mounted upright and fine wires are welded onto the chip pads and lead frame contacts to interconnect the chip pads to external circuitry.

In electronics manufacturing, integrated circuit packaging is the final stage of semiconductor device fabrication, in which the block of semiconductor material is encapsulated in a supporting case that prevents physical damage and corrosion. The case, known as a "package", supports the electrical contacts which connect the device to a circuit board.

A quad flat package (QFP) is a surface-mounted integrated circuit package with "gull wing" leads extending from each of the four sides. Socketing such packages is rare and through-hole mounting is not possible. Versions ranging from 32 to 304 pins with a pitch ranging from 0.4 to 1.0 mm are common. Other special variants include low-profile QFP (LQFP) and thin QFP (TQFP).

In electronics, a lead is an electrical connection consisting of a length of wire or a metal pad that is designed to connect two locations electrically. Leads are used for many purposes, including: transfer of power; testing of an electrical circuit to see if it is working, using a test light or a multimeter; transmitting information, as when the leads from an electrocardiograph are attached to a person's body to transmit information about their heart rhythm; and sometimes to act as a heatsink. The tiny leads coming off through-hole electronic components are also often called pins; in ball grid array packages, they are in form of small spheres, and are therefore called "balls".

Tape-automated bonding (TAB) is a process that places bare semiconductor chips (dies) like integrated circuits onto a flexible circuit board (FPC) by attaching them to fine conductors in a polyamide or polyimide film carrier. This FPC with the die(s) can be mounted on the system or module board or assembled inside a package. Typically the FPC includes from one to three conductive layers and all inputs and outputs of the semiconductor die are connected simultaneously during the TAB bonding. Tape automated bonding is one of the methods needed for achieving chip-on-flex (COF) assembly and it is one of the first roll-to-roll processing type methods in the electronics manufacturing.

Flat no-leads packages such as quad-flat no-leads (QFN) and dual-flat no-leads (DFN) physically and electrically connect integrated circuits to printed circuit boards. Flat no-leads, also known as micro leadframe (MLF) and SON, is a surface-mount technology, one of several package technologies that connect ICs to the surfaces of PCBs without through-holes. Flat no-lead is a near chip scale plastic encapsulated package made with a planar copper lead frame substrate. Perimeter lands on the package bottom provide electrical connections to the PCB. Flat no-lead packages include an exposed thermally conductive pad to improve heat transfer out of the IC. Heat transfer can be further facilitated by metal vias in the thermal pad. The QFN package is similar to the quad-flat package (QFP), and a ball grid array (BGA).
A semiconductor package is a metal, plastic, glass, or ceramic casing containing one or more discrete semiconductor devices or integrated circuits. Individual components are fabricated on semiconductor wafers before being diced into die, tested, and packaged. The package provides a means for connecting it to the external environment, such as printed circuit board, via leads such as lands, balls, or pins; and protection against threats such as mechanical impact, chemical contamination, and light exposure. Additionally, it helps dissipate heat produced by the device, with or without the aid of a heat spreader. There are thousands of package types in use. Some are defined by international, national, or industry standards, while others are particular to an individual manufacturer.

Soldering is a process in which two or more items are joined by melting and putting a filler metal (solder) into the joint, the filler metal having a lower melting point than the adjoining metal. Unlike welding, soldering does not involve melting the work pieces. In brazing, the work piece metal also does not melt, but the filler metal is one that melts at a higher temperature than in soldering. In the past, nearly all solders contained lead, but environmental and health concerns have increasingly dictated use of lead-free alloys for electronics and plumbing purposes.
Copper–tungsten is a mixture of copper and tungsten. As copper and tungsten are not mutually soluble, the material is composed of distinct particles of one metal dispersed in a matrix of the other one. The microstructure is therefore rather a metal matrix composite instead of a true alloy.
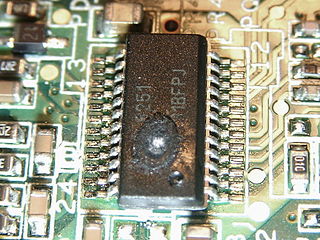
Electronic components have a wide range of failure modes. These can be classified in various ways, such as by time or cause. Failures can be caused by excess temperature, excess current or voltage, ionizing radiation, mechanical shock, stress or impact, and many other causes. In semiconductor devices, problems in the device package may cause failures due to contamination, mechanical stress of the device, or open or short circuits.

Compliant bonding is used to connect gold wires to electrical components such as integrated circuit "chips". It was invented by Alexander Coucoulas in the 1960s. The bond is formed well below the melting point of the mating gold surfaces and is therefore referred to as a solid-state type bond. The compliant bond is formed by transmitting heat and pressure to the bond region through a relatively thick indentable or compliant medium, generally an aluminum tape.
Glossary of microelectronics manufacturing terms