Force spectroscopy is a set of techniques for the study of the interactions and the binding forces between individual molecules. These methods can be used to measure the mechanical properties of single polymer molecules or proteins, or individual chemical bonds. The name "force spectroscopy", although widely used in the scientific community, is somewhat misleading, because there is no true matter-radiation interaction.

Atomic force microscopy (AFM) or scanning force microscopy (SFM) is a very-high-resolution type of scanning probe microscopy (SPM), with demonstrated resolution on the order of fractions of a nanometer, more than 1000 times better than the optical diffraction limit.
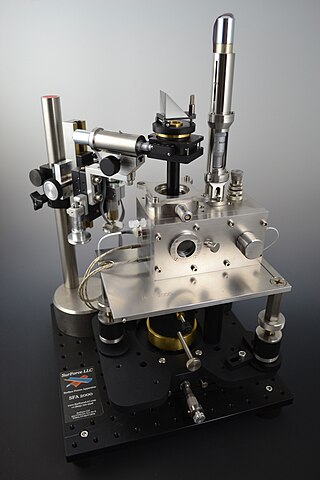
The Surface Force Apparatus (SFA) is a scientific instrument which measures the interaction force of two surfaces as they are brought together and retracted using multiple beam interferometry to monitor surface separation and directly measure contact area and observe any surface deformations occurring in the contact zone. One surface is held by a cantilevered spring, and the deflection of the spring is used to calculate the force being exerted. The technique was pioneered by David Tabor and R.H.S. Winterton in the late 1960s at Cambridge University. By the mid-1970s, J.N. Israelachvili had adapted the original design to operate in liquids, notably aqueous solutions, while at the Australian National University, and further advanced the technique to support friction and electro-chemical surface studies while at the University of California Santa Barbara.

Magnetic force microscopy (MFM) is a variety of atomic force microscopy, in which a sharp magnetized tip scans a magnetic sample; the tip-sample magnetic interactions are detected and used to reconstruct the magnetic structure of the sample surface. Many kinds of magnetic interactions are measured by MFM, including magnetic dipole–dipole interaction. MFM scanning often uses non-contact AFM (NC-AFM) mode.

Kelvin probe force microscopy (KPFM), also known as surface potential microscopy, is a noncontact variant of atomic force microscopy (AFM). By raster scanning in the x,y plane the work function of the sample can be locally mapped for correlation with sample features. When there is little or no magnification, this approach can be described as using a scanning Kelvin probe (SKP). These techniques are predominantly used to measure corrosion and coatings.
Nanotribology is the branch of tribology that studies friction, wear, adhesion and lubrication phenomena at the nanoscale, where atomic interactions and quantum effects are not negligible. The aim of this discipline is characterizing and modifying surfaces for both scientific and technological purposes.
Electrostatic force microscopy (EFM) is a type of dynamic non-contact atomic force microscopy where the electrostatic force is probed.. This force arises due to the attraction or repulsion of separated charges. It is a long-range force and can be detected 100 nm or more from the sample.

Nanometrology is a subfield of metrology, concerned with the science of measurement at the nanoscale level. Nanometrology has a crucial role in order to produce nanomaterials and devices with a high degree of accuracy and reliability in nanomanufacturing.

In materials science, chemical force microscopy (CFM) is a variation of atomic force microscopy (AFM) which has become a versatile tool for characterization of materials surfaces. With AFM, structural morphology is probed using simple tapping or contact modes that utilize van der Waals interactions between tip and sample to maintain a constant probe deflection amplitude or maintain height while measuring tip deflection. CFM, on the other hand, uses chemical interactions between functionalized probe tip and sample. Choice chemistry is typically gold-coated tip and surface with R−SH thiols attached, R being the functional groups of interest. CFM enables the ability to determine the chemical nature of surfaces, irrespective of their specific morphology, and facilitates studies of basic chemical bonding enthalpy and surface energy. Typically, CFM is limited by thermal vibrations within the cantilever holding the probe. This limits force measurement resolution to ~1 pN which is still very suitable considering weak COOH/CH3 interactions are ~20 pN per pair. Hydrophobicity is used as the primary example throughout this consideration of CFM, but certainly any type of bonding can be probed with this method.

Total internal reflection microscopy is a specialized optical imaging technique for object tracking and detection utilizing the light scattered from an evanescent field in the vicinity of a dielectric interface. Its advantages are a high signal-to-noise ratio and a high spatial resolution in the vertical dimension.

Piezoresponse force microscopy (PFM) is a variant of atomic force microscopy (AFM) that allows imaging and manipulation of piezoelectric/ferroelectric materials domains. This is achieved by bringing a sharp conductive probe into contact with a ferroelectric surface and applying an alternating current (AC) bias to the probe tip in order to excite deformation of the sample through the converse piezoelectric effect (CPE). The resulting deflection of the probe cantilever is detected through standard split photodiode detector methods and then demodulated by use of a lock-in amplifier (LiA). In this way topography and ferroelectric domains can be imaged simultaneously with high resolution.
In microscopy, scanning joule expansion microscopy (SJEM) is a form of scanning probe microscopy heavily based on atomic force microscopy (AFM) that maps the temperature distribution along a surface. Resolutions down to 10 nm have been achieved and 1 nm resolution is theoretically possible. Thermal measurements at the nanometer scale are of both academic and industrial interest, particularly in regards to nanomaterials and modern integrated circuits.

Photoconductive atomic force microscopy (PC-AFM) is a variant of atomic force microscopy that measures photoconductivity in addition to surface forces.
The technique of vibrational analysis with scanning probe microscopy allows probing vibrational properties of materials at the submicrometer scale, and even of individual molecules. This is accomplished by integrating scanning probe microscopy (SPM) and vibrational spectroscopy. This combination allows for much higher spatial resolution than can be achieved with conventional Raman/FTIR instrumentation. The technique is also nondestructive, requires non-extensive sample preparation, and provides more contrast such as intensity contrast, polarization contrast and wavelength contrast, as well as providing specific chemical information and topography images simultaneously.
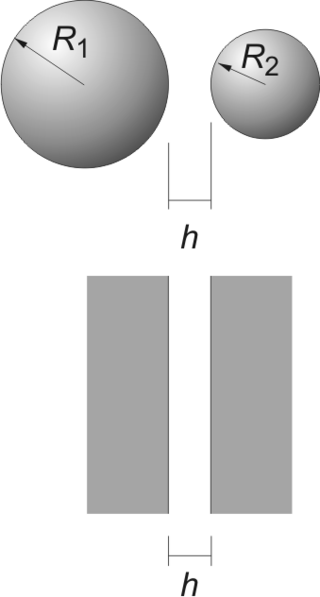
The Derjaguin approximation (or sometimes also referred to as the proximity approximation), named after the Russian scientist Boris Derjaguin, expresses the force profile acting between finite size bodies in terms of the force profile between two planar semi-infinite walls. This approximation is widely used to estimate forces between colloidal particles, as forces between two planar bodies are often much easier to calculate. The Derjaguin approximation expresses the force F(h) between two bodies as a function of the surface separation as
A depletion force is an effective attractive force that arises between large colloidal particles that are suspended in a dilute solution of depletants, which are smaller solutes that are preferentially excluded from the vicinity of the large particles. One of the earliest reports of depletion forces that lead to particle coagulation is that of Bondy, who observed the separation or "creaming" of rubber latex upon addition of polymer depletant molecules to solution. More generally, depletants can include polymers, micelles, osmolytes, ink, mud, or paint dispersed in a continuous phase.

Non-contact atomic force microscopy (nc-AFM), also known as dynamic force microscopy (DFM), is a mode of atomic force microscopy, which itself is a type of scanning probe microscopy. In nc-AFM a sharp probe is moved close to the surface under study, the probe is then raster scanned across the surface, the image is then constructed from the force interactions during the scan. The probe is connected to a resonator, usually a silicon cantilever or a quartz crystal resonator. During measurements the sensor is driven so that it oscillates. The force interactions are measured either by measuring the change in amplitude of the oscillation at a constant frequency just off resonance or by measuring the change in resonant frequency directly using a feedback circuit to always drive the sensor on resonance.

AFM-IR or infrared nanospectroscopy is one of a family of techniques that are derived from a combination of two parent instrumental techniques. AFM-IR combines the chemical analysis power of infrared spectroscopy and the high-spatial resolution of scanning probe microscopy (SPM). The term was first used to denote a method that combined a tuneable free electron laser with an atomic force microscope equipped with a sharp probe that measured the local absorption of infrared light by a sample with nanoscale spatial resolution.
The operation of a photon scanning tunneling microscope (PSTM) is analogous to the operation of an electron scanning tunneling microscope, with the primary distinction being that PSTM involves tunneling of photons instead of electrons from the sample surface to the probe tip. A beam of light is focused on a prism at an angle greater than the critical angle of the refractive medium in order to induce total internal reflection within the prism. Although the beam of light is not propagated through the surface of the refractive prism under total internal reflection, an evanescent field of light is still present at the surface.
A probe tip is an instrument used in scanning probe microscopes (SPMs) to scan the surface of a sample and make nano-scale images of surfaces and structures. The probe tip is mounted on the end of a cantilever and can be as sharp as a single atom. In microscopy, probe tip geometry and the composition of both the tip and the surface being probed directly affect resolution and imaging quality. Tip size and shape are extremely important in monitoring and detecting interactions between surfaces. SPMs can precisely measure electrostatic forces, magnetic forces, chemical bonding, Van der Waals forces, and capillary forces. SPMs can also reveal the morphology and topography of a surface.