In integrated circuit manufacturing, photolithography or optical lithography is a general term used for techniques that use light to produce minutely patterned thin films of suitable materials over a substrate, such as a silicon wafer, to protect selected areas of it during subsequent etching, deposition, or implantation operations. Typically, ultraviolet light is used to transfer a geometric design from an optical mask to a light-sensitive chemical (photoresist) coated on the substrate. The photoresist either breaks down or hardens where it is exposed to light. The patterned film is then created by removing the softer parts of the coating with appropriate solvents.

Semiconductor device fabrication is the process used to manufacture semiconductor devices, typically integrated circuit (IC) "chips" such as computer processors, microcontrollers, and memory chips such as NAND flash and DRAM that are present in everyday electrical and electronic devices. It is a multiple-step sequence of photolithographic and physico-chemical processing steps during which electronic circuits are gradually created on a wafer typically made of pure single-crystal semiconducting material. Silicon is almost always used, but various compound semiconductors are used for specialized applications.
Dry etching refers to the removal of material, typically a masked pattern of semiconductor material, by exposing the material to a bombardment of ions that dislodge portions of the material from the exposed surface. A common type of dry etching is reactive-ion etching. Unlike with many of the wet chemical etchants used in wet etching, the dry etching process typically etches directionally or anisotropically.
Surface micromachining builds microstructures by deposition and etching structural layers over a substrate. This is different from Bulk micromachining, in which a silicon substrate wafer is selectively etched to produce structures.
Bulk micromachining is a process used to produce micromachinery or microelectromechanical systems (MEMS).
In semiconductor fabrication, a resist is a thin layer used to transfer a circuit pattern to the semiconductor substrate which it is deposited upon. A resist can be patterned via lithography to form a (sub)micrometer-scale, temporary mask that protects selected areas of the underlying substrate during subsequent processing steps. The material used to prepare said thin layer is typically a viscous solution. Resists are generally proprietary mixtures of a polymer or its precursor and other small molecules that have been specially formulated for a given lithography technology. Resists used during photolithography are called photoresists.
Deep reactive-ion etching (DRIE) is a highly anisotropic etch process used to create deep penetration, steep-sided holes and trenches in wafers/substrates, typically with high aspect ratios. It was developed for microelectromechanical systems (MEMS), which require these features, but is also used to excavate trenches for high-density capacitors for DRAM and more recently for creating through silicon vias (TSVs) in advanced 3D wafer level packaging technology. In DRIE, the substrate is placed inside a reactor, and several gases are introduced. A plasma is struck in the gas mixture which breaks the gas molecules into ions. The ions accelerated towards, and react with the surface of the material being etched, forming another gaseous element. This is known as the chemical part of the reactive ion etching. There is also a physical part, if ions have enough energy, they can knock atoms out of the material to be etched without chemical reaction.

Microfabrication is the process of fabricating miniature structures of micrometre scales and smaller. Historically, the earliest microfabrication processes were used for integrated circuit fabrication, also known as "semiconductor manufacturing" or "semiconductor device fabrication". In the last two decades microelectromechanical systems (MEMS), microsystems, micromachines and their subfields, microfluidics/lab-on-a-chip, optical MEMS, RF MEMS, PowerMEMS, BioMEMS and their extension into nanoscale have re-used, adapted or extended microfabrication methods. Flat-panel displays and solar cells are also using similar techniques.
Plasma etching is a form of plasma processing used to fabricate integrated circuits. It involves a high-speed stream of glow discharge (plasma) of an appropriate gas mixture being shot at a sample. The plasma source, known as etch species, can be either charged (ions) or neutral. During the process, the plasma generates volatile etch products at room temperature from the chemical reactions between the elements of the material etched and the reactive species generated by the plasma. Eventually the atoms of the shot element embed themselves at or just below the surface of the target, thus modifying the physical properties of the target.

Etching is used in microfabrication to chemically remove layers from the surface of a wafer during manufacturing. Etching is a critically important process module, and every wafer undergoes many etching steps before it is complete.
Adhesive bonding describes a wafer bonding technique with applying an intermediate layer to connect substrates of different types of materials. Those connections produced can be soluble or insoluble. The commercially available adhesive can be organic or inorganic and is deposited on one or both substrate surfaces. Adhesives, especially the well-established SU-8, and benzocyclobutene (BCB), are specialized for MEMS or electronic component production.
Stencil lithography is a novel method of fabricating nanometer scale patterns using nanostencils, stencils with nanometer size apertures. It is a resist-less, simple, parallel nanolithography process, and it does not involve any heat or chemical treatment of the substrates .

Veeco is a global capital equipment supplier, headquartered in the U.S., that designs and builds processing systems used in semiconductor and compound semiconductor manufacturing, data storage and scientific markets for applications such as advanced packaging, photonics, power electronics and display technologies.

The Nano and Micro Devices Center (NMDC) is a research center located at the University of Alabama in Huntsville. The center forms the backbone of nanotechnology research in the university. It operates a level 4 clean room as well as several other lab facilities.
Anodic bonding is a wafer bonding process to seal glass to either silicon or metal without introducing an intermediate layer; it is commonly used to seal glass to silicon wafers in electronics and microfluidics. This bonding technique, also known as field assisted bonding or electrostatic sealing, is mostly used for connecting silicon/glass and metal/glass through electric fields. The requirements for anodic bonding are clean and even wafer surfaces and atomic contact between the bonding substrates through a sufficiently powerful electrostatic field. Also necessary is the use of borosilicate glass containing a high concentration of alkali ions. The coefficient of thermal expansion (CTE) of the processed glass needs to be similar to those of the bonding partner.

Eutectic bonding, also referred to as eutectic soldering, describes a wafer bonding technique with an intermediate metal layer that can produce a eutectic system. Those eutectic metals are alloys that transform directly from solid to liquid state, or vice versa from liquid to solid state, at a specific composition and temperature without passing a two-phase equilibrium, i.e. liquid and solid state. The fact that the eutectic temperature can be much lower than the melting temperature of the two or more pure elements can be important in eutectic bonding.
Reactive bonding describes a wafer bonding procedure using highly reactive nanoscale multilayer systems as an intermediate layer between the bonding substrates. The multilayer system consists of two alternating different thin metallic films. The self-propagating exothermic reaction within the multilayer system contributes the local heat to bond the solder films. Based on the limited temperature the substrate material is exposed, temperature-sensitive components and materials with different CTEs, i.e. metals, polymers and ceramics, can be used without thermal damage.
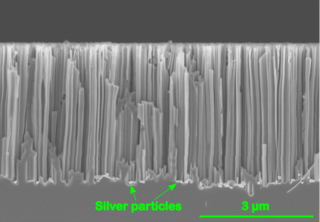
Metal Assisted Chemical Etching is the process of wet chemical etching of semiconductors with the use of a metal catalyst, usually deposited on the surface of a semiconductor in the form of a thin film or nanoparticles. The semiconductor, covered with the metal is then immersed in an etching solution containing and oxidizing agent and hydrofluoric acid. The metal on the surface catalyzes the reduction of the oxidizing agent and therefore in turn also the dissolution of silicon. In the majority of the conducted research this phenomenon of increased dissolution rate is also spatially confined, such that it is increased in close proximity to a metal particle at the surface. Eventually this leads to the formation of straight pores that are etched into the semiconductor. This means that a pre-defined pattern of the metal on the surface can be directly transferred to a semiconductor substrate.
Vapor etching refers to a process used in the fabrication of Microelectromechanical systems (MEMS) and Nanoelectromechanical systems (NEMS). Sacrificial layers are isotropically etched using gaseous acids such as Hydrogen fluoride and Xenon difluoride to release the free standing components of the device.
Glossary of microelectronics manufacturing terms