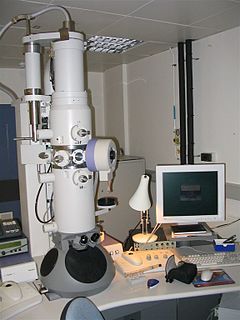
An electron microscope is a microscope that uses a beam of accelerated electrons as a source of illumination. As the wavelength of an electron can be up to 100,000 times shorter than that of visible light photons, electron microscopes have a higher resolving power than light microscopes and can reveal the structure of smaller objects. A scanning transmission electron microscope has achieved better work than 50 pm resolution in annular dark-field imaging mode and magnifications of up to about 10,000,000× whereas most light microscopes are limited by diffraction to about 200 nm resolution and useful magnifications below 2000×.

A microscope is an instrument used to see objects that are too small to be seen by the naked eye. Microscopy is the science of investigating small objects and structures using such an instrument. Microscopic means invisible to the eye unless aided by a microscope.

A SQUID is a very sensitive magnetometer used to measure extremely subtle magnetic fields, based on superconducting loops containing Josephson junctions.

Atomic force microscopy (AFM) or scanning force microscopy (SFM) is a very-high-resolution type of scanning probe microscopy (SPM), with demonstrated resolution on the order of fractions of a nanometer, more than 1000 times better than the optical diffraction limit.
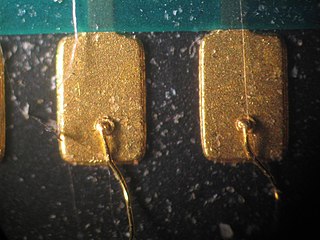
Wire bonding is the method of making interconnections (ATJ) between an integrated circuit (IC) or other semiconductor device and its packaging during semiconductor device fabrication. Although less common, wire bonding can be used to connect an IC to other electronics or to connect from one printed circuit board (PCB) to another. Wire bonding is generally considered the most cost-effective and flexible interconnect technology and is used to assemble the vast majority of semiconductor packages. Wire bonding can be used at frequencies above 100 GHz.
Scanning probe microscope (SPM) is a branch of microscopy that forms images of surfaces using a physical probe that scans the specimen. SPM was founded in 1981, with the invention of the scanning tunneling microscope, an instrument for imaging surfaces at the atomic level. The first successful scanning tunneling microscope experiment was done by Binnig and Rohrer. The key to their success was using a feedback loop to regulate gap distance between the sample and the probe.

A scanning transmission electron microscope (STEM) is a type of transmission electron microscope (TEM). Pronunciation is [stɛm] or [ɛsti:i:ɛm]. As with a conventional transmission electron microscope (CTEM), images are formed by electrons passing through a sufficiently thin specimen. However, unlike CTEM, in STEM the electron beam is focused to a fine spot which is then scanned over the sample in a raster illumination system constructed so that the sample is illuminated at each point with the beam parallel to the optical axis. The rastering of the beam across the sample makes STEM suitable for analytical techniques such as Z-contrast annular dark-field imaging, and spectroscopic mapping by energy dispersive X-ray (EDX) spectroscopy, or electron energy loss spectroscopy (EELS). These signals can be obtained simultaneously, allowing direct correlation of images and spectroscopic data.

An electronic component is any basic discrete device or physical entity in an electronic system used to affect electrons or their associated fields. Electronic components are mostly industrial products, available in a singular form and are not to be confused with electrical elements, which are conceptual abstractions representing idealized electronic components.
Failure analysis is the process of collecting and analyzing data to determine the cause of a failure, often with the goal of determining corrective actions or liability. According to Bloch and Geitner, machinery failures reveal a reaction chain of cause and effect… usually a deficiency commonly referred to as the symptom…”. failure analysis can save money, lives, and resources if done correctly and acted upon. It is an important discipline in many branches of manufacturing industry, such as the electronics industry, where it is a vital tool used in the development of new products and for the improvement of existing products. The failure analysis process relies on collecting failed components for subsequent examination of the cause or causes of failure using a wide array of methods, especially microscopy and spectroscopy. Nondestructive testing (NDT) methods are valuable because the failed products are unaffected by analysis, so inspection sometimes starts using these methods.

Focused ion beam, also known as FIB, is a technique used particularly in the semiconductor industry, materials science and increasingly in the biological field for site-specific analysis, deposition, and ablation of materials. A FIB setup is a scientific instrument that resembles a scanning electron microscope (SEM). However, while the SEM uses a focused beam of electrons to image the sample in the chamber, a FIB setup uses a focused beam of ions instead. FIB can also be incorporated in a system with both electron and ion beam columns, allowing the same feature to be investigated using either of the beams. FIB should not be confused with using a beam of focused ions for direct write lithography. These are generally quite different systems where the material is modified by other mechanisms.

Characterization, when used in materials science, refers to the broad and general process by which a material's structure and properties are probed and measured. It is a fundamental process in the field of materials science, without which no scientific understanding of engineering materials could be ascertained. The scope of the term often differs; some definitions limit the term's use to techniques which study the microscopic structure and properties of materials, while others use the term to refer to any materials analysis process including macroscopic techniques such as mechanical testing, thermal analysis and density calculation. The scale of the structures observed in materials characterization ranges from angstroms, such as in the imaging of individual atoms and chemical bonds, up to centimeters, such as in the imaging of coarse grain structures in metals.
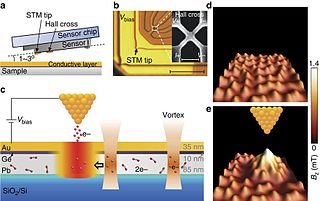
Scanning Hall probe microscope (SHPM) is a variety of a scanning probe microscope which incorporates accurate sample approach and positioning of the scanning tunnelling microscope with a semiconductor Hall sensor. This combination allows mapping the magnetic induction associated with a sample. Current state of the art SHPM systems utilize 2D electron gas materials to provide high spatial resolution (~300 nm) imaging with high magnetic field sensitivity. Unlike the magnetic force microscope the SHPM provides direct quantitative information on the magnetic state of a material. The SHPM can also image magnetic induction under applied fields up to ~1 tesla and over a wide range of temperatures.
Reliability of semiconductor devices can be summarized as follows:
- Semiconductor devices are very sensitive to impurities and particles. Therefore, to manufacture these devices it is necessary to manage many processes while accurately controlling the level of impurities and particles. The finished product quality depends upon the many layered relationship of each interacting substance in the semiconductor, including metallization, chip material and package.
- The problems of micro-processes, and thin films and must be fully understood as they apply to metallization and wire bonding. It is also necessary to analyze surface phenomena from the aspect of thin films.
- Due to the rapid advances in technology, many new devices are developed using new materials and processes, and design calendar time is limited due to non-recurring engineering constraints, plus time to market concerns. Consequently, it is not possible to base new designs on the reliability of existing devices.
- To achieve economy of scale, semiconductor products are manufactured in high volume. Furthermore, repair of finished semiconductor products is impractical. Therefore, incorporation of reliability at the design stage and reduction of variation in the production stage have become essential.
- Reliability of semiconductor devices may depend on assembly, use, and environmental conditions. Stress factors affecting device reliability include gas, dust, contamination, voltage, current density, temperature, humidity, mechanical stress, vibration, shock, radiation, pressure, and intensity of magnetic and electrical fields.

Scanning SQUID microscopy is a technique where a superconducting quantum interference device (SQUID) is used to image surface magnetic field strength with micrometre scale resolution. A tiny SQUID is mounted onto a tip which is then rastered near the surface of the sample to be measured. As the SQUID is the most sensitive detector of magnetic fields available and can be constructed at submicrometre widths via lithography, the scanning SQUID microscope allows magnetic fields to be measured with unparalleled resolution and sensitivity. The first scanning SQUID microscope was built in 1992 by Black et al. Since then the technique has been used to confirm unconventional superconductity in several high-temperature superconductors including YBCO and BSCCO compounds.
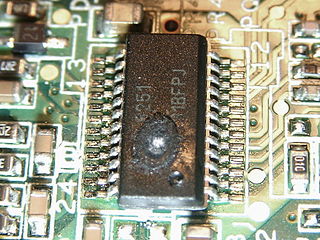
Electronic components have a wide range of failure modes. These can be classified in various ways, such as by time or cause. Failures can be caused by excess temperature, excess current or voltage, ionizing radiation, mechanical shock, stress or impact, and many other causes. In semiconductor devices, problems in the device package may cause failures due to contamination, mechanical stress of the device, or open or short circuits.

A measuring instrument is a device for measuring a physical quantity. In the physical sciences, quality assurance, and engineering, measurement is the activity of obtaining and comparing physical quantities of real-world objects and events. Established standard objects and events are used as units, and the process of measurement gives a number relating the item under study and the referenced unit of measurement. Measuring instruments, and formal test methods which define the instrument's use, are the means by which these relations of numbers are obtained. All measuring instruments are subject to varying degrees of instrument error and measurement uncertainty. These instruments may range from simple objects such as rulers and stopwatches to electron microscopes and particle accelerators. Virtual instrumentation is widely used in the development of modern measuring instruments.
The wafer bond characterization is based on different methods and tests. Considered a high importance of the wafer are the successful bonded wafers without flaws. Those flaws can be caused by void formation in the interface due to unevenness or impurities. The bond connection is characterized for wafer bond development or quality assessment of fabricated wafers and sensors.

Non-contact atomic force microscopy (nc-AFM), also known as dynamic force microscopy (DFM), is a mode of atomic force microscopy, which itself is a type of scanning probe microscopy. In nc-AFM a sharp probe is moved close to the surface under study, the probe is then raster scanned across the surface, the image is then constructed from the force interactions during the scan. The probe is connected to a resonator, usually a silicon cantilever or a quartz crystal resonator. During measurements the sensor is driven so that it oscillates. The force interactions are measured either by measuring the change in amplitude of the oscillation at a constant frequency just off resonance or by measuring the change in resonant frequency directly using a feedback circuit to always drive the sensor on resonance.
Nanoprobing is method of extracting device electrical parameters through the use of nanoscale tungsten wires, used primarily in the semiconductor industry. The characterization of individual devices is instrumental to engineers and integrated circuit designers during initial product development and debug. It is commonly utilized in device failure analysis laboratories to aid with yield enhancement, quality and reliability issues and customer returns. Commercially available nanoprobing systems are integrated into either a vacuum-based scanning electron microscope (SEM) or atomic force microscope (AFM). Nanoprobing systems that are based on AFM technology are referred to as Atomic Force nanoProbers (AFP).